用于通孔硅(TSV)与通孔玻璃(TGV)
的先进薄膜涂层
TSV 与 TGV:IC 封装的下一次飞跃
随着 IC 封装从传统引线键合向硅与玻璃中介层演进,通孔硅(TSV)与通孔玻璃(TGV)已成为实现系统级性能扩展的关键技术。AI/HPC 加速器、HBM 高带宽存储集成以及毫米波(mmWave)应用的快速增长,正推动 2.5D/3D 架构与面板级玻璃基板的广泛采用,使通孔尺寸不断向更深、更窄的发展。
这一转变使电气与机械应力高度集中于中介层,对高纵横比金属化、有效的扩散阻挡以及长期热可靠性提出了更高要求,直接关系到良率与成本控制。
推动 TSV 与 TGV 采用的封装路线
当前 IC 封装从传统引线键合到先进的 2.5D/3D 中介层并存:TSV 主要驱动 AI/HPC 与 HBM 系统,TGV 则在 5G、毫米波与光子学领域快速发展。扇出型封装与异构 SiP 正在移动与汽车市场持续扩展,而倒装芯片(Flip-Chip)、WLCSP 以及引线键合在成本敏感型应用中仍保持稳定需求。
高纵横比(AR)金属化挑战
关键涂层要求
TSV 与 TGV 制造需要在整个结构中实现均匀沉积的阻挡层、附着层与种子层。
工艺限制
在纵横比 AR > 5:1 的特征结构中,传统工艺在覆盖性、处理速度与可靠性方面面临显著挑战。
对制造经济性的影响
上述限制将导致良率下降、成本上升,并增加系统集成的复杂度。
FCVA 涂层在 TSV/TGV 中的作用
TSV 与 TGV 制造对超共形的阻挡层与种子层提出了严苛要求,需要具备强附着力、低内应力以及无缺陷覆盖的能力;而传统 PVD、湿法电镀修复方案或堆叠式且节拍缓慢的 ALD,在规模化量产与成本效率方面往往难以兼顾。
NTI Nanofilm 的专有 过滤阴极真空弧(FCVA) 技术独特地融合了以下优势:
- 高纵横比(High-AR)通孔覆盖,并通过离子辅助实现卓越附着力
- 致密、无针孔的 ta-C / DLC 阻挡层
- 低温沉积(<100 °C)
- 单一设备实现阻挡层 + 种子层的一体化能力
这些特性可帮助晶圆厂简化工艺流程、提升电镀良率,并在热循环过程中保障可靠性,从而解锁面向下一代封装的可规模化 TSV/TGV 集成。
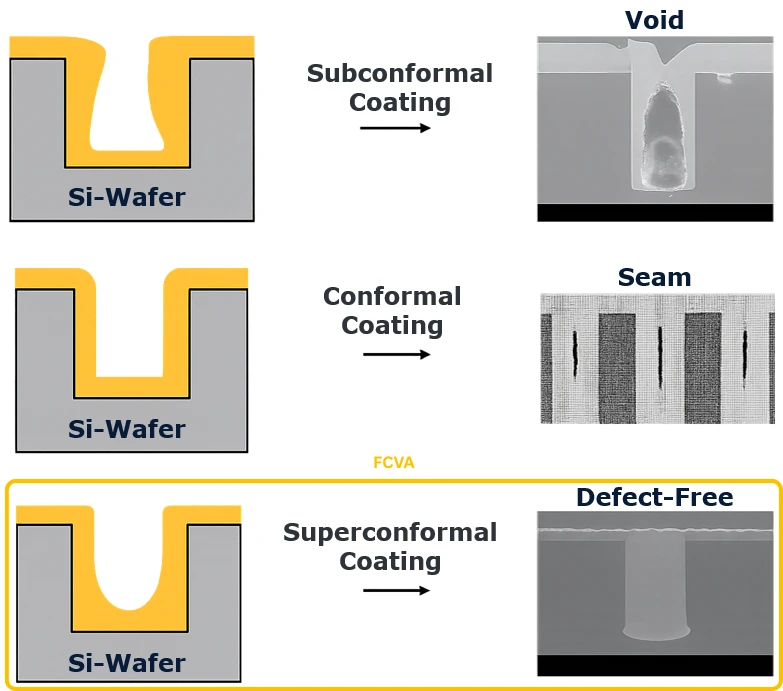
已验证能力:FCVA 在高纵横比通孔中的阻挡层与种子层性能
FCVA 可在单一设备内完成高纵横比通孔中阻挡层与种子层的沉积,减少工艺步骤,同时提升集成简化度与整体良率。
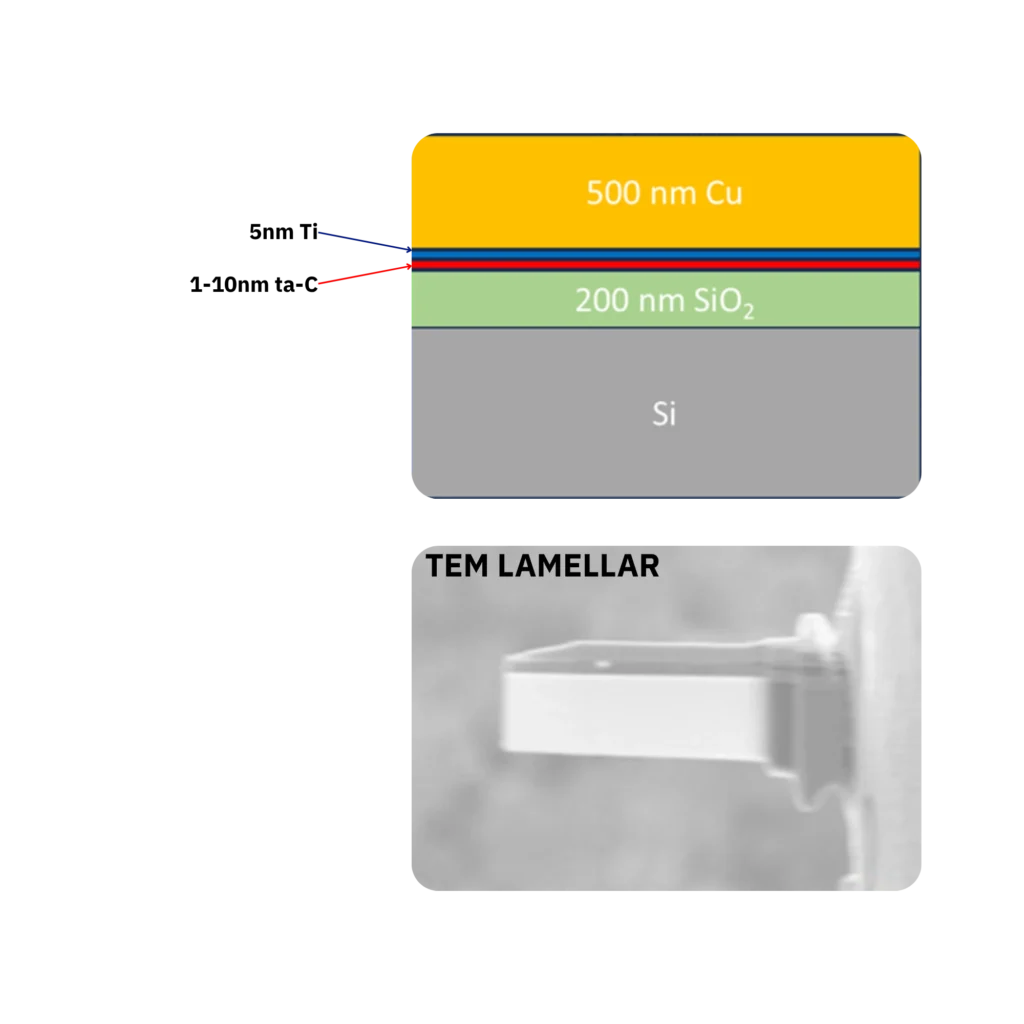
测试结构:包含 1 nm ta-C 薄膜
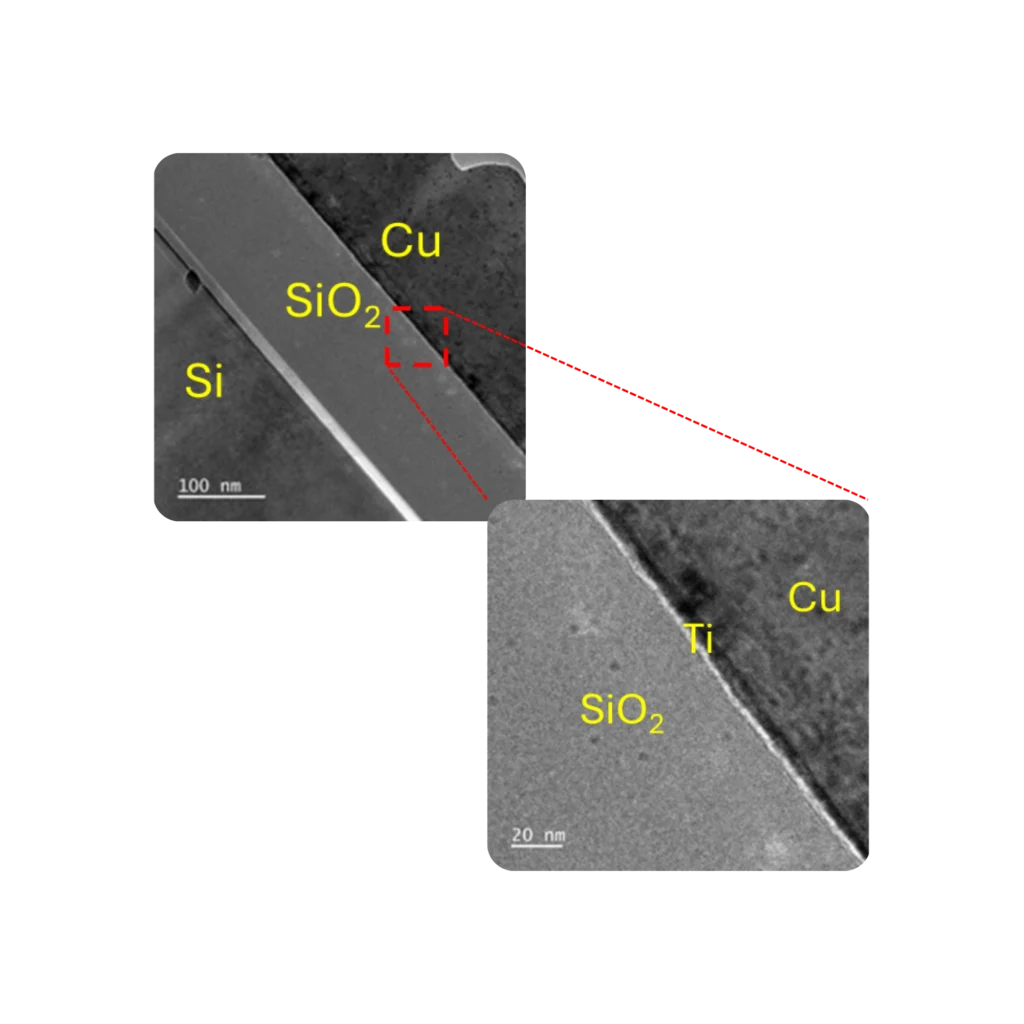
经 X-TEM 与 ToF-SIMS 分析验证:在 600 °C、40 分钟的高温退火条件下,铜(Cu)未通过 1 nm ta-C 层在 Ti 与 SiO₂ 之间发生扩散,证明其卓越的阻挡性能与热稳定性。
通过 FCVA 解锁性能、良率与成本优势
环境合规
干式真空工艺,消除有害湿化学废液,满足严格的环保与合规要求。
通孔良率提升
在深通孔中实现可靠的共形覆盖,减少电镀空洞与返工风险。
可规模化制造
当前已具备晶圆级量产能力,并可平滑扩展至面板级生产。
工艺简化
单一设备完成阻挡层 / 种子层沉积,减少工艺步骤、缩短节拍并降低总体拥有成本(TCO)。
可靠性增强
致密的扩散阻挡层与强界面结合,有效抵御热循环过程中的分层与铜(Cu)迁移。
低温兼容性
支持玻璃基板及先进异构集成堆栈应用。
为超共形深通孔阻挡层 / 种子层选择合适的技术路线
在深通孔阻挡层 / 种子层的沉积方案对比中,FCVA 以单一洁净真空工艺,独特地融合了高纵横比通孔覆盖、离子键合级附着力、无针孔的致密结构以及 <100 °C 的低温沉积能力。
| 能力指标 | PVD(溅射) | 化学镀(无电镀) | ALD/CVD(化学沉积) | NTI Nanofilm FCVA |
|---|---|---|---|---|
| 高纵横比通孔的步覆率 | 受限(约 ≤ 5:1) | 较好;可修复种子层但致密性偏低 | ALD:极佳 CVD:优于 PVD |
高纵横比通孔覆盖性优秀,且膜层致密 |
| 对玻璃/硅的附着力 | 中等 | 不稳定(依赖前处理/活化) | 配合表面预处理后较好 | 高(离子注入、梯度界面) |
| 膜层致密度与阻挡质量 | 中等 | 低–中(NiP/Cu) | ALD:高致密衬层 CVD:中–高 |
高、无针孔(ta-C 约 3.3 g/cm³) |
| 沉积温度 | 低(<200 °C) | 低 | ALD:低–中(<200 °C) CVD:中–高(>300 °C) |
低(<100 °C) |
| 吞吐量与厚度可行性 | 薄膜速度快;厚膜共形性较难 | 速率较好、共形;但增加湿法步骤 | ALD:>50 nm 时非常慢 CVD:中等–较快 |
沉积速率高(薄–中厚);单机完成 |
| 工艺复杂度 | 往往需要化学镀修复 | 多槽工艺 + 废液处理 | 常与 PVD/种子层配套 | 可单步完成 |
| 环境足迹 | 低–中 | 高(湿化学废液) | 低–中(前驱体/尾气处理) | 低(干式真空) |
| 热循环下的可靠性 | 薄弱区域/种子层脱层风险 | 附着力波动 | 衬层表现好;依赖堆栈设计 | 强附着力;致密阻挡层抗扩散 |
常见问题 (FAQ)
TSV 与 TGV 在先进封装中解决了哪些核心问题?
TSV 与 TGV 通过缩短互连长度、提升 I/O 密度并降低信号损耗,实现更高带宽、更低延迟与更好的功耗效率,是 AI/HPC、HBM、毫米波与光子学系统实现 2.5D/3D 集成的关键技术。
为什么高纵横比(High-AR)通孔对阻挡层与种子层如此关键?
随着通孔尺寸变得更深更窄,电气与机械应力高度集中在中介层。若阻挡层或种子层覆盖不均,将导致铜扩散、电镀空洞、界面失效,从而直接影响良率、可靠性与成本。
传统 PVD、化学镀或 ALD 在 TSV/TGV 中面临哪些限制?
传统 PVD 在 AR >5:1 时共形性不足;化学镀依赖湿法工艺,附着力与一致性受限;ALD 虽具高共形性,但沉积速率慢、成本高,难以经济地规模化应用于量产。
FCVA 技术如何提升 TSV/TGV 的良率与可靠性?
FCVA 通过离子辅助沉积,在高纵横比通孔中实现致密、无针孔的 ta-C/DLC 阻挡层,并具备强附着力与低内应力,可有效抑制铜扩散、减少电镀缺陷,并在热循环下保持长期稳定性。
FCVA 是否适用于玻璃基板与下一代封装路线?
是的。FCVA 支持 <100 °C 的低温沉积,兼容玻璃中介层、面板级基板及异构集成堆栈,同时具备从晶圆级到面板级制造的可扩展性,满足下一代 TSV/TGV 封装的发展需求。